Tel Number
180-3717-8440
Company Statement" Zhengzhou KJ Technology Co., Ltd. " belongs to the international business department of KJ Group. Starting today, the company will continue the international business contract signed or currently being performed by " Zhengzhou Kejia Furnace Co., Ltd. " See details >>




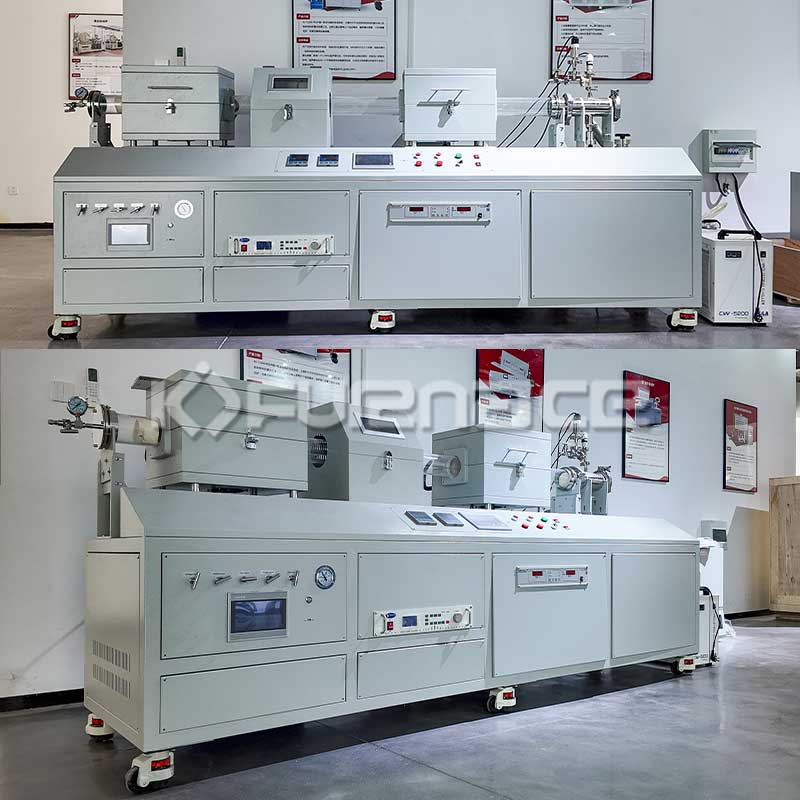
Description:
PECVD with Load Lock System is used for execution of plasma enhanced chemical vapor deposition procedure in semiconductor arena. Utilization of this system can also be noticed in microelectronics arena. Vacuum loadlock of this system has significant rol...

| Model | KJ-T1200-PECVD | ||
| Part I: Standard Parts----Pre-heating furnace | |||
| Pre-heating furnace (LCD) | Max Temp | 1200C | |
| Working Temp. | ≤ 1100C | ||
| Hot zone | OD60mm*200mm heating zone Customizable | ||
|
Part III : Standard Parts----Tube Furnace |
|||
| Tube Furnace |
Chamber | Split type and upper part can be opened | |
| Max. Temp. | 1200℃ for short time | ||
| Continuous Woking Temp. | ≤1100℃ | ||
| Heating Rate | Suggestion: 0~10℃/min (max. 20℃/min) |
||
| Heating Zone | 300mm Customizable | ||
| Heating Element | Fe-Cr-Al Alloy doped by Mo | ||
| Thermocouple | N type | ||
| Temperature Control Accuracy | ±1℃ | ||
| Tube Size | 60mm OD X Length 1500 mm Customizable | ||
| Material: Quarz Tube |
|||
| Temperature Control | PID automatic control via SCR power control | ||
| Heating curves | 30 steps programmable | ||
| Vacuum Flange | Stainless Steel vacuum flange with valve | ||
| Part IV : Standard Parts---vacuum pump | |||
| Vacuum Pump System |
Diffusion pump system Pumping rate:1000L/S Compsite digital vacuum gauge The rotary vane vacuum pump will be designed into a cart with wheel. |
||
| Part V: Standard Parts----Gsa system | |||
| Mass Flow Meters LCD Touch Screen |
Four precision mass flow meters : MFC1:0~100 sccm: H2 (Hydrogen) MFC2:0~200 sccm: O2 (Oxygen) MFC3:0~200 sccm: N2 (Nitrogen) MFC4:0~500 sccm: He (Helium) One gas mixing tank is installed on bottom case with 4 stainless steel needle valves is installed on left side of bottom case to control 4 type gases mixing manually |
||
| Water ChilLer | Used for Diffusion pump. | ||

South Africa Laboratory | Rotary Tube Pyrolysis Furnace

Pilot-scale rotary kilns have helped US customers innovate in new energy, enabling them to successfu

Malaysian customers came to our factory to inspect the magnetron sputtering coating equipment
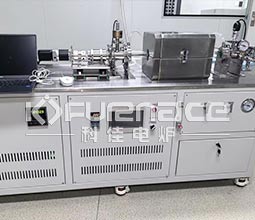
PECVD for carbon nanotube growth

Research group of Tsinghua University in China visited the factory











Professional Process, Effortless Purchase
Click to inquire
 E-mail:web@kejiafurnace.com
E-mail:web@kejiafurnace.com
 Tell:+(86) 18037178440
Tell:+(86) 18037178440
 Whatapp:+(86) 180-3717-8440
Whatapp:+(86) 180-3717-8440
 Address:Room 1505, Building 9, No. 26 Dongqing Street, Zhengzhou High-tech Industrial Development Zone
Address:Room 1505, Building 9, No. 26 Dongqing Street, Zhengzhou High-tech Industrial Development Zone

Tel Number
180-3717-8440
web@kejiafurnace.com
YouTuBe